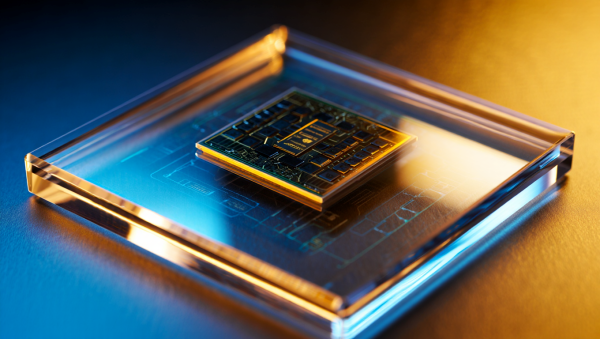
人工知能(AI)チップの次世代パッケージ材料として、ガラス基板が有力候補に浮上している。半導体業界では、ガラスを用いた先端パッケージが、AIデータセンターで深刻化する電力負荷と演算性能の制約の緩和につながる可能性があるとの見方が広がっている。Technology Reviewが現地時間13日に報じた。
SKCの米子会社Absolicsは、次世代コンピューティング向け特殊ガラスパネルの商業生産に向けた準備を進めている。米国ではAIチップ向けガラス基板の生産工場をすでに完成させており、2026年中に顧客向けの少量生産を始める計画だ。Intelも、次世代パッケージへのガラス基板採用に向けた研究を続けている。
注目されるのは、複数のシリコンチップを接続する基板にガラスを使う点だ。半導体設計では近年、機能の異なるチップを1つのシステムとして統合する実装技術が広がっている。一方、従来の有機基板は発熱時に反り(ワーページ)が生じやすく、チップの位置ずれや冷却効率の低下を招く恐れがある。
AMDの研究者、ディパク・クルカルニは、AI演算の増加に伴ってパッケージが大型化し、基板の変形がより深刻な課題になっていると指摘した。そのうえで、ガラス基板はこうした機械的制約を和らげる代替策になり得ると説明した。ガラスは熱安定性が高く、従来基板より高温に耐えられるため、パッケージの小型化と性能・エネルギー効率の両立が期待されるという。
現在の半導体パッケージは、ガラス繊維強化エポキシなどの有機基板への依存度が高い。Intelで先端パッケージを担当する副社長ラフル・マネパリは、有機基板には電気的・熱的な限界があると指摘する。ガラス基板を採用すれば、同じ面積でも接続密度を大幅に高められ、チップ間配線の高密度化が可能になるほか、同一パッケージ面積に最大50%多くのチップを搭載できるとしている。
ガラスは表面を極めて滑らかに加工できる点も利点だ。調査会社IDTechExによると、ガラス基板の表面平滑性は有機基板比で最大5000倍に達し、チップ性能の低下要因となる微細欠陥を減らせる可能性がある。さらに、ガラスには光を導く特性があり、基板内部に光信号伝送を組み込める。実現すれば、銅配線より大幅に低い電力でデータを伝送できる可能性がある。
もっとも、課題も残る。基板は厚さが数百マイクロメートルと非常に薄く、製造工程で割れやすいためだ。Intelの研究チームは最近、ガラス基板を適用したテスト用チップパッケージを試作し、そのパッケージ上でオペレーティングシステム(OS)の起動を確認したと明らかにした。
市場拡大も見込まれている。IDTechExは、ガラス基板市場が2025年の約10億ドルから、2036年には44億ドルに拡大すると予測している。
この技術は、2009年に米ジョージア工科大学の3Dシステムパッケージング研究センターでの研究に端を発する。その後、AbsolicsはSKCと協力し、2024年に米ジョージア州コビントンに生産施設を整備した。米政府の「CHIPS for America」プログラムを通じ、総額1億7500万ドルの支援も受けている。
ガラス基板を巡る競争は、業界全体に広がりつつある。Samsung Electronics、Samsung Electro-Mechanics、LG Innotekが研究と試験生産を拡大しているほか、部材メーカーJNTCも半加工ガラスパネルの生産設備を整え、サプライチェーンへの参画を進めている。
業界では、ガラス基板はまずAIデータセンター向けの高性能チップで採用が進み、その後、量産効果でコストが下がればノートPCやモバイル機器にも広がる可能性があるとみられている。AI演算需要が急増するなか、ガラスが次世代コンピューティングを支える基幹材料となるかが焦点になりそうだ。
