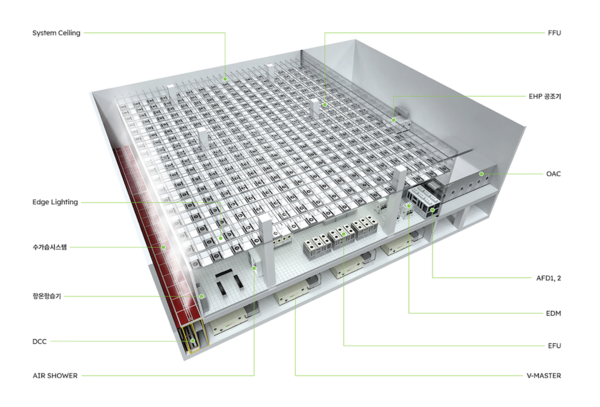
Shinsung E&Gは1月16日、半導体装置向けに、除湿と静電気除去を同時に行う特許技術を発表した。EFEMチャンバー内に除湿ユニットとイオナイザーを一体化した構成で、省スペース化と汚染抑制の両立を狙う。
同社が公表したのは、イオナイザーを組み込んだEFEMチャンバーに関する特許技術だ。チャンバー内部に除湿ユニットとイオナイザーを搭載することで、設置スペースを抑えながら静電気対策にも対応できるという。
半導体の微細化が進む中、ウエハーへのパーティクル付着や製造環境の汚染管理に対する要求は一段と高まっている。従来は装置内部の湿度を下げるため、EFEMの外部に除湿空気供給装置を別途設置する必要があった。
その場合、配管接続が必要となるため、装置の大型化を招き、設置スペースの確保が課題になっていた。Shinsung E&Gは、除湿ユニットをチャンバー上部に配置し、ファンフィルターユニットと一体化した。
これにより、外部の除湿装置や配管を不要にし、装置全体の省スペース化を実現したという。半導体ファブのスペース効率を高めるほか、製造コストの削減にもつながるとしている。
一方、低湿環境では静電気が発生しやすくなり、ウエハー表面へのパーティクル付着リスクが高まる。これに対応するため、同社は除湿ユニット下部とフィルターの間にイオナイザーを配置した。
除湿後の清浄空気中で静電気を速やかに除去することで、パーティクルの付着を抑える。従来はパーティクル対策として送風ファンの風量を高める必要があったが、イオナイザーの適用により、過度に風量を上げることなく汚染を防ぎ、消費エネルギーも抑えられるとしている。
Shinsung E&Gは、「数十年にわたり蓄積してきたクリーンルームおよび空調(HVAC)分野の技術力を基に、今回の技術を完成させた」とコメントした。その上で、「HBM(高帯域幅メモリ)をはじめとする先端半導体パッケージングや超微細工程の重要性が高まる中、当社の精密制御技術はグローバル半導体メーカーの生産性向上を支える中核ソリューションになる」としている。
